电子元器件导热界面材料有哪些?
随着电子电器的集成密度和功率密度的不断增加,大功率LED的兴起等,电子器件在工作时会释放出很多热量,导热性能差会使电器工作环境温度急剧上升,影响电子器件运行稳定性甚至造成器件损坏,如果不采取点积极措施它们分分钟就被自己放出的超额热量“烧坏脑子了”,据称电子元器件的温度每升高2℃,其可靠性下降10%!,举个鲜活的例子,电脑跟手机一发烫就卡死的烦恼谁还没体验过呢。而目前热界面材料与其他器件相比热导率相差几个数量级,因此热界面材料已成为提高电子产品散热性能的瓶颈之一,下文咱们来一起聊聊“热界面材料”。

电子电器界不得不得说材料:TIM
一、什么是热界面材料
热界面材料(ThermalInterfaceMaterials,TIM)是一种用于两种材料间的填充物,是热传递的重要桥梁。当两种材料相互接合时,无论是同种材料还是两种不同的材料,即使材料表面平整度很好或施加很大的扣合压力,仍无法达到紧密接触,只能是部分接触,中间一定仍然存在许多微细空隙或孔洞,如下图a所示。空隙间的空气为热传导率相当差的传热介质,会阻碍热传导的路径,增加热阻抗。因此,需要填充一种热界面材料于两种接合材料间,以填补空隙,增进热的传递效率,降低热阻抗,如下图b所示。它是一种应用相当广泛而且非常重要的材料。
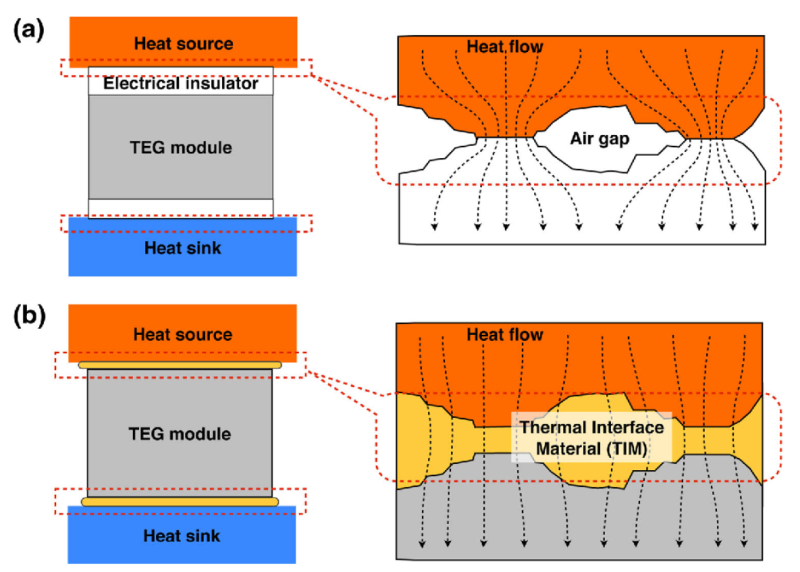
▲有TIM及冇TIM示意图
如上所述,热界面材料主要用于填补两种材料接触面间的空隙,降低热阻抗,因此,热传导系数K就是评估热界面材料的重要特性之一。热界面材料应具备以下基本特性:可压缩性及柔软性;高热传导性;低热阻尼;表面湿润性;适当的黏性;对扣合压力的敏感性要高;使用方便;可重复使用;冷热循环的稳定性好等特点。
高分子材料(聚合物材料)能够很好的满足以上要求,但是一般的高分子材料(高能的本征导热高分子除外,实在太贵消费不起)热传导系数最好的也只有0.1-0.2W/m.K左右,热传递能力实在是差极,所以往往需要添加热传导率较高20-1000W/m.K的无机粉末或金属粉末或石墨粉来制备成聚合物基导热复合材料改善其热传导性。导热复合材料中,常用金属导热填料有Cu、Ag、Al等;而在要求一定绝缘性能的情况下,需要选用非金属导热填料,比如陶瓷类,如MgO、Al2O3、BN、AlN等,石墨烯、碳纳米管、金刚石等也是现在研究热门对象,此外,也可将多种填料混合使用。

▲导热填料高手高高手:六方氮化硼
二、电子元器件导热界面材料有哪些?
依其TIM特性不同及发展可简单分成几类∶导热膏、弹性导热布、相变型导热胶、导热凝胶、导热黏胶及导热带等。
↓↓↓各种导热界面材料特征

↓↓↓各种导热界面材料优缺点

1、导热膏(导热硅脂)
导热膏是一种传统的散热材料,粘稠状的液体,具有较强的粘性。一般约在100-400Pa压力下使用,其界面热阻值大约在0.2-1.0K·cm²/W左右。基材主要成分是硅油和非硅质的高分子聚合物,导热填充料一般以AIN及ZnO为主,也可以选用BN、Al2O3或SiC等陶瓷粉末或铝粉、银粉、石墨粉,甚至金刚石粉末等来提升其热传导性。但要特别注意这些填充料在基材内的分散性及混合后的粘性控制。

导热膏由于不需要固化处理属于液态材料,因此可以添加较高体积比的填充料,热传导率比其他热界面材料高。目前市售的导热膏的热传导率通常介于2-6W/m.K之间,好的可大于8W/m·K,热阻约介于0.2-0.6W/m·K。导热膏本身具有一定的流动性,不需要太高的扣合压力,经压缩后其接合厚度可以变得相当薄,对降低热阻有很大帮助。但缺点是易产生溢出及相分离问题。
2.弹性导热布
弹性导热布是由导热膏衍生出来的一种散热材料,一般主要是由在聚硅氧烷橡胶化合物中添加各种不同导热粉体(如 BN、Al2O3等)所构成,且以玻璃纤维布作载体形成容易操作的固体形态。加工操作较简单,一般在 700KPa 左右的压力下使用,其界面热阻值约为1.0-3.0K*cm²/W。弹性导热布可用于标准 TO型晶体管的热管理组装技术上。
3、相变导热材料(PhaseChangeMaterials,PCMs)
相变导热材料可以是有机材料也可以是金属合金。相变导热材料融合了导热胶和导热油脂的双重有点,在达到相变温度前,其特性与导热胶类似具有一定的粘性,因此不会在扣压时发生Pump out问题。当电子器件工作时温度不断升高至材料熔点时,PCMs发生相变成为液态,具有和导热油脂一样的填充空隙的能力,热阻因而大幅度降低。目前相变导热材料主要用于CPU散热材料。
就有机相变导热材料而言,相变导热胶主要以热塑性聚合物为基体,如聚烯烃、低分子量的聚乙烯和丙烯酸树脂,添加低熔点的固体石蜡,并添加高导热填料制备而成的。其中石蜡是主要的发生相变的材料,相变的温度一般控制在45-60℃。现行的有机相变材料热导率普遍在1-3W/mK。
4、导热凝胶
导热凝胶一般是由在硅油及石蜡中添加铝粉、氧化铝及银粉等导热填充料组成,通常需进行固化处理。由于经过了交链处理,所以具有较强的内凝聚力特性,使用时无需加热或冷凝。它能提供比导热胶及粘胶剂更有效的传热路径,其热传导率约在1-3W/m.K左右。导热凝胶的优点是能顺应接触表面的不规则性而填补孔隙。此外,由于其内凝聚力较强,在使用时不会有溢出及移动问题,使用和处理起来都很方便,其缺点是需固化处理。

5、导热黏胶
导热胶是发展较早的产品,其主要组成是树脂基体、导热填料、稀释性溶剂或者是反应型稀释剂、固化剂和添加剂。用于电子胶黏剂的树脂基体主要包括:环氧树脂、聚酰亚胺、有机硅胶、聚氨酯、丙烯酸酯和氰酸酯等。
6、导热带(Tapes)
导热带的开发主要是为了做热沉Heat Sink贴合材料。主要目的是为了取消外力夹合装置,降低设备成本。导热带主要是将添加导热粉体的压敏胶涂在支撑材料上(如玻璃布、聚亚酰胺薄膜或铝箔)上所构成的。导热胶带属于压敏胶的一种,使用方便。导热带的使用非常方便,和一般胶布的贴合方式相同。一般来讲,导热带主要应用其粘胶性能其次才是散热性能,且只能应用于表面平整的界面上。

本文标题:电子元器件导热界面材料有哪些?
本文链接:https://www.blueocean-china.net/faq1/294.html [版权声明]除非特别标注,否则均为本站原创文章,转载时请以链接形式注明文章出处。